- 品牌
- PARKWELLER
- 型号
- TS 500-65
- 产品名称
- 可固型单组份导热凝胶
- 硬化/固化方式
- 加温硬化
- 主要粘料类型
- 合成热固性材料
- 基材
- 有机硅胶
- 物理形态
- 膏状型
- 性能特点
- 高导热率,高挤出率,低挥发,低渗油
- 用途
- 5G通讯设备,光通讯设备,消费电子设备
- 挤出速率
- 110 g/min
- 阻燃等级
- UL94-V0
- 低挥发
- D4~D10<100ppm
- 导热率
- 6.5 W/m·K
- 热阻
- 0.77℃·cm²/W
- 压力/BLT
- 20 psi/160µm
- 固化条件
- 30min @ 100℃
笔记本电脑等消费电子设备朝着轻薄化、高性能方向发展,其CPU、GPU等关键元件的散热空间不断压缩,传统导热垫片因厚度固定难以适配复杂的元件表面,而导热硅脂则存在易挥发、长期使用后性能衰减的问题。可固型单组份导热凝胶TS500系列恰好解决这一痛点,其在20psi压力下可实现60-160μm的灵活厚度覆盖,能紧密贴合消费电子元件的微观不平表面,形成完整的导热通路。同时,该凝胶加热固化后形成的导热结构稳定性强,避免了传统硅脂的挥发损耗,而TS500-B4型号115g/min的高挤出速率,也能满足消费电子大规模量产的节奏需求。对于消费电子厂商而言,无需调整现有组装产线,只通过适配固化参数(30min@100℃或60min@100℃),即可快速导入该凝胶,可靠提升设备的散热效率与长期可靠性。可固型单组份导热凝胶凭借高导热系数,可靠解决5G设备的散热焦虑。广东高挤出高导热可固型单组份导热凝胶芯片热管理
可固型单组份导热凝胶
电子制造业的产线效率提升是企业降本增效的关键方向,传统多组份导热材料需现场称重、混合,操作繁琐且易出现混合不均的问题,除了影响生产节拍,还会导致产品良率波动。可固型单组份导热凝胶TS500系列在施工便捷性上实现了关键突破:单组份形态省去了复杂的混合步骤,打开包装后即可通过自动化点胶设备直接涂覆,大幅简化操作流程;TS500-B4型号115g/min的高挤出速率,能匹配高速产线的涂覆需求,相比传统导热材料的施工效率提升很多。同时,该凝胶涂覆后能快速流平,紧密贴合元件表面,无需额外按压或调整,减少了人工干预带来的误差。对于追求精益生产的厂商而言,这种施工便捷性除了降低了人工成本,还能缩短生产周期,提升整体产能,成为卓效生产流程中的关键配套材料。安徽半导体芯片可固型单组份导热凝胶芯片热管理可固型单组份导热凝胶TS500-X2 12W/m・K高导热,解决5G设备散热难题。
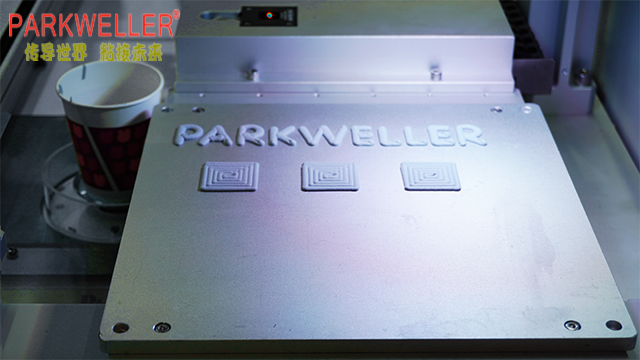
AI服务器作为人工智能算力支撑的关键设备,其GPU、CPU等关键芯片的功率密度很高,运行时产生的海量热量若无法及时散出,会导致算力下降、宕机风险增加,对导热材料的导热效率与稳定性提出极其要求。可固型单组份导热凝胶TS500系列为AI服务器提供卓效散热方案:TS500-X2型号12W/m・K的高导热系数,能快速构建卓效导热通路,将芯片热量导出至散热模组;低至0.36℃・cm²/W的热阻(TS500-80型号),减少热量传导损耗,确保芯片在适配温度区间稳定运行。同时,该凝胶单组份形态无需混合,配合115g/min的高挤出速率,可适配AI服务器规模化量产的自动化产线需求;固化后形成的稳定结构能抵抗服务器运行时的震动,长期使用中导热性能衰减不超过5%,为AI算力集群的持续运行提供可靠确保。
北欧地区冬季漫长寒冷,户外电子设备(如道路监控、通信基站)需在-30℃以下的低温环境中正常运行,传统导热材料易因低温脆裂,导致导热界面断裂,影响设备散热。可固型单组份导热凝胶TS500系列针对北欧低温环境优化:固化后的导热结构在-40℃低温下仍保持良好的柔韧性,无脆裂、脱落现象,能紧密贴合元件表面,确保低温下导热通路畅通;即使在低温启动时,凝胶固化后的结构稳定性不受影响,可快速传导设备启动瞬间产生的热量,避免低温热冲击损坏元件。其灵活的固化条件可适配设备自带的加热系统,无需额外增加保温设备,降低部署成本;UL94V-0的阻燃级别与高导热系数,在满足低温环境使用需求的同时,确保设备安全稳定运行,为北欧地区户外电子设备提供可靠的低温适配导热解决方案。帕克威乐可固型单组份导热凝胶集高导热与低渗油于一体,适配多场景应用。

在5G通讯基站的AAU(有源天线单元)模块中,设备长期处于户外复杂环境,除了需要卓效散热确保信号处理芯片的稳定运行,还需避免导热材料因渗油或挥发对内部精密元件造成污染。可固型单组份导热凝胶TS500系列凭借热固化特性,在加热固化后能形成稳定的导热界面,其低渗油(D4-D10<100ppm)和低挥发特性,可靠杜绝了传统导热硅脂因渗油导致的元件短路风险,同时UL94V-0的阻燃级别也满足基站设备的安全标准。针对AAU模块的组装需求,该凝胶在20psi压力下可实现60-160μm的厚度覆盖,适配不同规格的芯片与散热结构,而灵活的固化条件(30min@100℃或60min@100℃)也能与基站设备的量产流程卓效匹配,帮助通讯设备厂商在确保散热性能的同时,提升生产效率。可固型单组份导热凝胶高挤出速率特性,降低光通信模块装配的时间成本。电源模块散热可固型单组份导热凝胶芯片热管理
可固型单组份导热凝胶低渗油(D4-D10<100ppm),确保消费电子内部洁净度。广东高挤出高导热可固型单组份导热凝胶芯片热管理
电子元件微型化是当前电子行业的关键发展趋势,芯片尺寸持续缩小、功率密度不断提升,传统导热材料因体积大、适配性差,难以满足微型元件的散热需求。可固型单组份导热凝胶TS500系列紧跟元件微型化趋势,展现出精确的适配能力:在20psi压力下可实现60-160μm的超薄厚度覆盖,能轻松适配微型芯片的狭小安装空间,不会占用额外体积,契合电子设备小型化的设计理念;流体状态的特性使其能填充微型元件表面的微小缝隙,形成完整的导热通路,避免因缝隙导致的散热死角;单组份形态与高挤出速率,适配微型元件的精密点胶需求,可通过高精度点胶设备实现精确涂覆,不会出现溢胶污染周边元件的情况,为电子行业向“更小、更精、更强”发展提供了关键导热支撑。广东高挤出高导热可固型单组份导热凝胶芯片热管理
帕克威乐新材料(深圳)有限公司汇集了大量的优秀人才,集企业奇思,创经济奇迹,一群有梦想有朝气的团队不断在前进的道路上开创新天地,绘画新蓝图,在广东省等地区的精细化学品中始终保持良好的信誉,信奉着“争取每一个客户不容易,失去每一个用户很简单”的理念,市场是企业的方向,质量是企业的生命,在公司有效方针的领导下,全体上下,团结一致,共同进退,齐心协力把各方面工作做得更好,努力开创工作的新局面,公司的新高度,未来帕克威乐新材料供应和您一起奔向更美好的未来,即使现在有一点小小的成绩,也不足以骄傲,过去的种种都已成为昨日我们只有总结经验,才能继续上路,让我们一起点燃新的希望,放飞新的梦想!
- 广东可固型单组份导热凝胶 2026-04-30
- 安徽电源模块散热可固型单组份导热凝胶 2026-04-29
- 天津快速固化可固型单组份导热凝胶性能参数 2026-04-28
- 湖南长期稳定可固型单组份导热凝胶工业散热 2026-04-27
- 四川低挥发低渗油可固型单组份导热凝胶电子散热 2026-04-27
- 电源模块散热可固型单组份导热凝胶散热解决方案 2026-04-27
- 湖南光通信可固型单组份导热凝胶样品试用 2026-04-24
- 重庆AI服务器可固型单组份导热凝胶生产厂家直销 2026-04-24





